news center
過去十年,半導體領域最大的故事之一就是電力電子領域意外超越傳統硅的碳化硅(SiC)和氮化鎵(GaN)占領了價值數十億美元的細分市場。隨著主要應用落入這些具有優越屬性的新貴手中,一個問題自然而然地出現了。
下一個新型功率半導體是什么——其卓越的能力能否將從 SiC 和 GaN 手中奪取主要市場份額?
人們的注意力集中在三種候選材料上:氧化鎵、金剛石和氮化鋁(AlN)。它們都具有顯著的特性,但也存在迄今為止阻礙商業成功的根本弱點。然而,現在,得益于最近的幾項突破,包括名古屋大學在去年 12 月于舊金山舉行的最新IEEE 國際電子器件會議上報告的一項技術進步,AlN 的前景已大大改善。

圖1 日本名古屋大學制造的氮化鋁二極管展示了半導體的顯著潛力 圖片來自:NAGOYA UNIVERSITY
一、氮化鋁如何趕上SiC 和 GaN
IEDM 論文描述了基于氮化鋁合金的二極管的制造方法,該二極管能夠承受每厘米 7.3 兆伏的電場,這個數字大約是碳化硅或氮化鎵所能承受的電場的兩倍。值得注意的是,該器件在傳導電流時也具有非常低的電阻。
“這是一個了不起的結果,”IEEE 高級會員、佐治亞理工學院電氣與計算機工程教授W. Alan Doolittle說道。“特別是這個東西的導通電阻,非常好。” 名古屋大學的論文有七位共同作者,其中包括 IEEE 會員天野浩(Hiroshi Amano),他因發明藍色 LED 而獲得 2014 年諾貝爾獎。
氮化鋁長期以來一直吸引著半導體研究人員。
功率半導體最重要的特性之一是其帶隙。它是半導體晶格中的電子從價帶躍遷到導帶所需的能量,以電子伏特為單位,在導帶中電子可以在晶格中自由移動并導電。在具有寬帶隙的半導體中,例如氮化鎵(GaN)或碳化硅(SiC),原子之間的鍵很強。因此,在鍵斷裂和晶體管被破壞之前,該材料能夠承受非常強的電場。但與 AlN 相比,它們都相形見絀。AlN的帶隙為6.20電子伏特;對于 GaN,該值為 3.40;對于最常見的 SiC 類型,該值為 3.26。
AlN 的一個長期存在的問題是摻雜,即插入雜質元素,使半導體產生過量電荷,從而使其能夠承載電流。化學摻雜 AlN 的策略近年來才開始出現,尚未完全成熟,其有效性在研究人員中是一個有爭議的話題。在摻雜過程中,多余的電荷可以是電子,在這種情況下,半導體被稱為“ n型”,或者它們可以是缺電子,稱為空穴,在這種情況下,半導體是“ p型”。幾乎所有商業上成功的器件都是由這種夾在一起的摻雜半導體組成。
但事實證明,雜質摻雜并不是摻雜半導體的唯一方法。
一些基于含有元素周期表中第 III 族(又名鈧族)和第 V 族(釩族)元素的化合物的半導體(例如化合物氮化鎵)具有不尋常且顯著的特性。在兩個這樣的半導體相遇的邊界處,即使沒有化學摻雜,它們也可以自發地產生一個由極高移動性的電荷載流子組成的二維池(two-dimensional pool ),稱為二維電子氣( 2-dimensional electron gas)。
它是由晶體內部電場產生的,而晶體內部電場具有幾個屬性:其一,這些 III-V 族半導體的晶體具有不同尋常的極性:在晶體的晶胞( unit cells)內,電子云和帶正電的原子核彼此偏移,足以為每個晶胞提供不同的負電區域和正電區域(偶極子:dipole)。此外,只需使晶格變形,就可以在這些半導體的晶格中產生電荷,這種現象稱為壓電(piezoelectricity)。
二、大進步背后的故事
2000 年代初期,加州大學圣塔芭芭拉分校的研究人員利用這些特性開發了一種稱為分布式極化摻雜(distributed polarization doping)的技術,該技術使他們能夠在沒有雜質的情況下獲得塊狀(三維)氮化鎵的n型摻雜。
該小組包括 IEEE 院士Umesh Mishra(現任 UCSB 工程系主任)和他的研究生Debdeep Jena和Huili(Grace)Xing,兩人現在都在康奈爾大學。Jena 和 Xing 都是 IEEE 院士,隨后于 2010 年在康奈爾大學演示了p型分布式極化摻雜,然后于 2018 年在康奈爾大學演示了無摻雜劑二維空穴氣體(hole gases)。
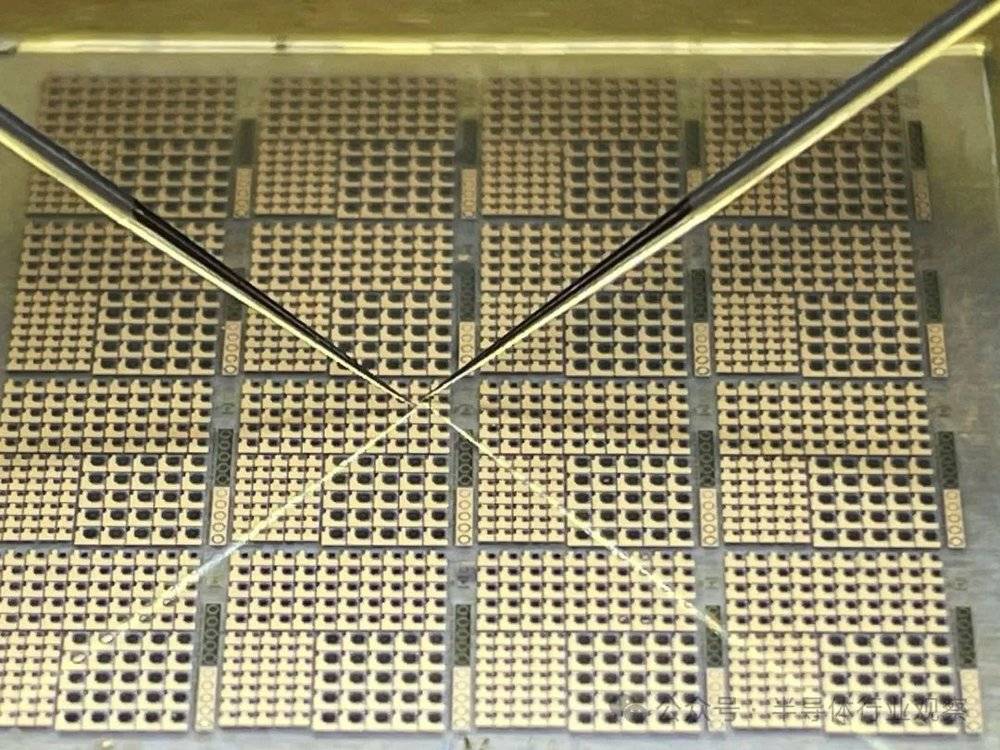
圖2 最先進的氮化鋁二極管正在進行測試 圖片來自:NAGOYA UNIVERSITY
名古屋小組在這些先前成果的基礎上,在氮化鋁(或更準確地說,由 AlN 和 GaN 的混合物組成的鋁鎵氮化物 (AlGaN)合金)中實施無摻雜劑分布式極化摻雜技術。
與任何二極管一樣,他們的器件具有與n摻雜區域配對的p摻雜區域,其間有一個稱為結(junction)的邊界。對于這兩個區域,摻雜都是通過分布式偏振摻雜(distributed polarization doping)來完成的。他們通過在每個摻雜區域建立合金中 AlN 與 GaN 百分比的梯度,實現了不同的極化( n型和p型)。摻雜是n型還是p型僅取決于梯度(gradient)的方向。
Jena 表示:“鋁成分不是均勻的 AlGaN 成分,而是以線性方式在空間上變化。” p摻雜層從鄰近陽極接觸一側的純氮化鎵開始。向帶有n摻雜層的結移動,AlGaN 合金中氮化鋁的百分比增加,直到在結處達到 95% 的 AlN。繼續沿相同方向移動,穿過n摻雜區域,AlN 的百分比隨著距結的距離的增加而下降,從 95% 開始,到最低點為 70%,其中該層與純 AlN 襯底接觸。
“這是半導體器件的一個新概念,”名古屋器件的 Jena 說道。他補充道,下一步是制造一種在結點處有一層純 AlN 的二極管,而不是 95% 的 AlN。根據他的計算,一層僅兩微米厚的氮化鋁就足以阻擋 3 千伏的電壓。“這正是在不久的將來將會發生的事情,”他說。
在佐治亞理工學院,Doolittle同意這種說法,通過在未來的設備中加入更高含量的純氮化鋁,仍有巨大的改進空間。例如,名古屋二極管的擊穿電場為 7.3 MV/cm,令人印象深刻,但 AlN 器件的理論最大值約為 15。更多的 AlN 也會大大提高熱導率。導熱能力對于功率器件至關重要,而 AlGaN 合金的導熱率一般,低于 50瓦每米開爾文。另一方面,純氮化鋁的 320 ℃ 值非常可觀,介于 GaN(250 ℃)和 SiC(490 ℃)之間。
Jena 和 Doolittle 表示,最終目標是商用 AlN 功率晶體管,其性能大大優于現有的選擇,而名古屋的工作毫無疑問最終會實現這一目標。“目前這只是工程,”Doolittle 說。他們都指出,名古屋二極管是垂直器件,這是功率半導體的首選方向。在垂直器件中,電流從基板向上直接流到器件頂部的觸點,這種配置允許最大電流流動。
近年來,至少有六種基于 AlN 的晶體管被展示,但這些晶體管都不是垂直器件,也沒有一個具有與商用 GaN 或 SiC 晶體管競爭的特性。他們在設備的關鍵組件中也采用了 AlGaN。
名古屋論文的合著者、IEEE 會員Takeru Kumabe在給IEEE Spectrum的電子郵件中寫道:“我們相信利用分布式極化摻雜技術展示具有商業競爭力的[功率晶體管]...... 基于 AlN 的垂直異質結雙極晶體管由兩個p - n結組成,具有良好的功率和面積效率,是我們的目標器件,也是我們要實現的夢想。”
Kumabe 補充說,為了實現這個夢想,團隊將專注于更深入地了解電荷遷移率、“載流子壽命、臨界電場和深層缺陷”。還應該開發能夠生產高質量器件層并在加工過程中引入更少損壞的晶體生長和器件制造技術。”
“我們希望在 3~5 年內解決這些問題,并在 2030 年代實現基于 AlN 的功率器件的商業化,”他說。
三、全球首個氮化鋁晶體管
在2022年4月,NTT Corporation宣布,其已使用高品質氮化鋁(AlN)實現了晶體管的運行。
晶體管是半導體功率器件的重要組成部分,用于家用電子設備和電動汽車中的功率轉換,其效率的提高將有助于節能。用于超寬帶隙(UWBG)半導體的AlN具有大的擊穿電場,因此是用于實現低損耗、高壓功率器件的有前途的半導體材料。
據報道,NTT 已利用金屬有機化學氣相沉積(MOCVD)成功生產出高質量的 AlN,并開發了歐姆和肖特基接觸的形成方法。這些技術使我們能夠首次展示 AlN 晶體管。此外,即使在500°C的高溫下,AlN晶體管也表現出良好的器件特性。這些成果將有助于實現超低損耗功率器件和高溫電子器件。
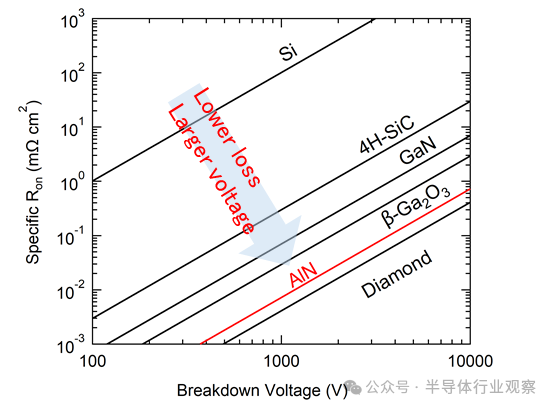
圖3:每種半導體材料的特定導通電阻和擊穿電壓之間的關系
NTT Corporation表示,用于功率轉換的半導體功率器件廣泛應用于家用電子產品、個人電腦和智能手機、以及數據庫服務器和電動汽車。近年來,功率器件的應用已擴展到光伏發電、鐵路等大功率運行領域。為了實現碳中和,電力設備的損耗應該進一步減少。硅(Si)通常用于半導體功率器件。通過使用具有大擊穿電場的寬帶隙半導體,可以減少損耗并提高擊穿電壓。
因此,正在開發用于功率器件的寬帶隙半導體,例如碳化硅(SiC)和氮化鎵(GaN)。擊穿場大于SiC或GaN的UWBG半導體進一步提高了功率器件的性能(圖3)。UWBG 半導體包括 AlN、金剛石和氧化鎵 (Ga2O3 )(表 I)。對于AlN功率器件,理論上功率損耗預計僅為Si的5%、SiC的35%、GaN的50%。
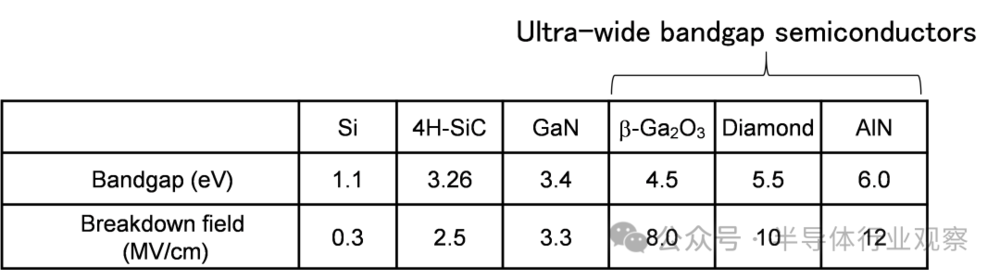
表1:半導體材料的帶隙能和擊穿場
自一個多世紀前首次合成以來,AlN 一直被用作絕緣體。2002年,NTT在世界上首次成功制造出半導體AlN,從而開辟了半導體器件應用的新途徑。在UWBG半導體中,AlN的優點在于可以在大規模晶圓上制造器件,并且可以通過與其他氮化物半導體(例如GaN)形成異質結來獲得各種器件結構。然而,關于這方面的功率器件制造的報道很少,并且其特性需要改進。
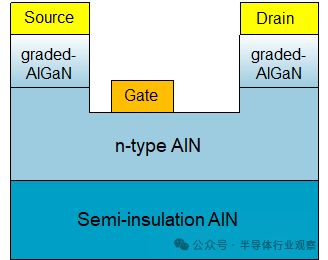
圖4:AlN 晶體管示意圖
NTT 首次使用 MOCVD 制造的高質量半導體 AlN 成功實現了具有良好特性的晶體管運行。AlN晶體管的電流-電壓特性顯示出良好的歐姆特性(圖4和圖5)和極小的漏電流。擊穿電壓高達1.7kV。
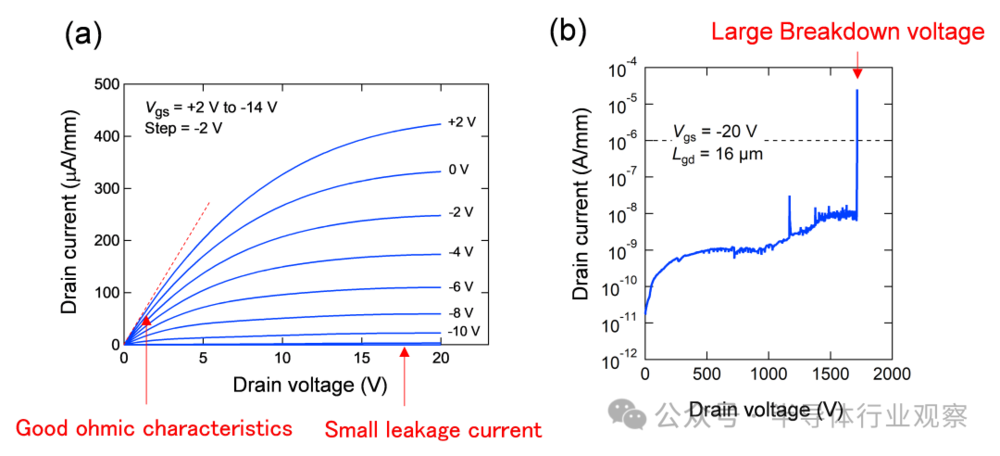
圖5:(a) AlN 晶體管的漏極電流與漏極電壓特性;(b) AlN晶體管的斷態擊穿特性。
NTT在新聞稿中強調,他們還證實了AlN晶體管可以在高溫下穩定工作(圖6)。與傳統半導體材料相比,AlN 晶體管在高溫下表現出更好的性能。隨著環境溫度從室溫升高到 500°C,漏極電流增加到約 100 倍。此外,即使在500℃下,漏電流也保持在10 -8 A/mm的極低水平。結果,在500℃下獲得了106的高漏極電流開/關比。
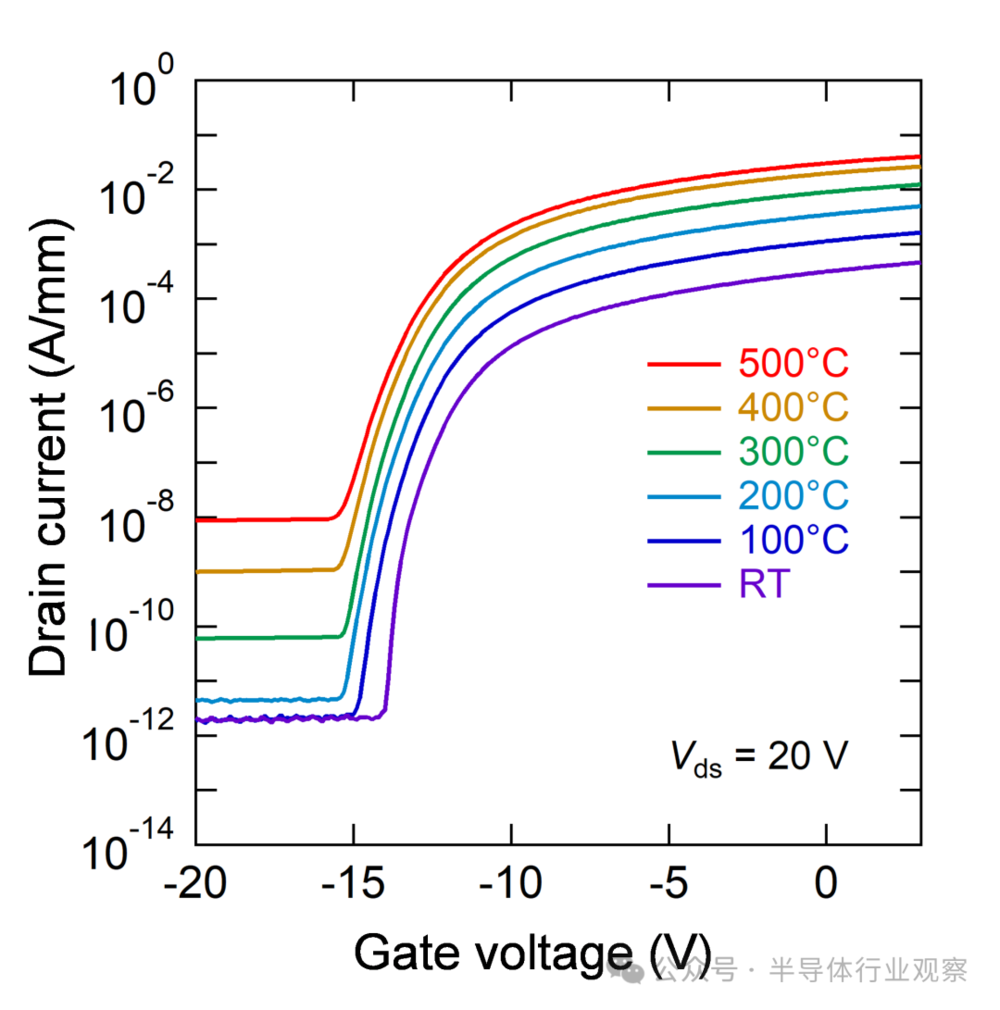
圖6:AlN 晶體管在室溫 (RT) 至 500°C 范圍內的漏極電流與柵極電壓特性
在NTT看來,要實現氮化鋁,需要解決以下技術問題:
首先要解決的技術問題是高質量AlN的晶體生長技術。通過采用特殊設計的反應器開發獨特的高溫 MOCVD,降低了 AlN 中殘留雜質和晶體缺陷的密度。由此,NTT 實現了具有世界最高電子遷移率的高質量 n 型 AlN 半導體。
第二點是如何實現良好的歐姆接觸。AlN對金屬具有較大的能壘,使其難以在其上形成歐姆接觸。NTT 在 AlN 和金屬電極之間使用了成分梯度的 AlGaN 層,以獲得良好的歐姆接觸(圖 7)。
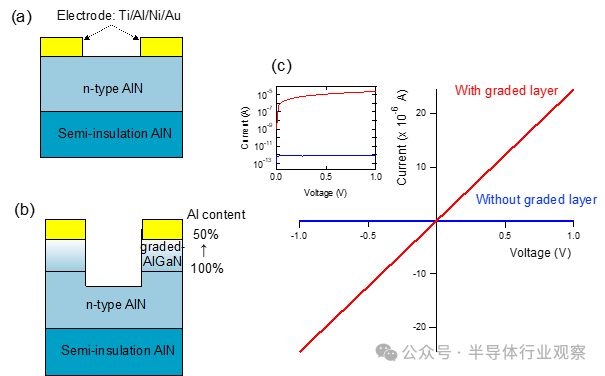
圖 7:金屬/n 型 AlN 接觸結構(a)具有和(b)不具有成分漸變的 AlGaN 層。(c) 有和沒有梯度層的電流-電壓特性。
第三點是如何實現肖特基接觸良好的整流。肖特基特性受半導體的晶體質量、半導體與金屬電極之間的界面狀態以及歐姆電極的接觸電阻的影響。如上所述,由于高質量的AlN和良好的歐姆接觸,NTT實現了近乎理想的肖特基特性和良好的整流性。
這些基本技術的建立導致了 AlN 晶體管的成功運行。在這些廠商和研究機構的努力下,半導體的未來指日可待。